簡介
射頻(RF)放大器可採用針腳架構晶片級封裝(LFCSP)和法蘭封裝,透過成熟的回流焊製程安裝在印刷電路板(PCB)上。PCB不僅充當元件之間的電氣互聯連接,還是放大器排熱的主要途徑(利用封裝底部的金屬塊)。
射頻(RF)放大器可採用針腳架構晶片級封裝(LFCSP)和法蘭封裝,透過成熟的回流焊製程安裝在印刷電路板(PCB)上。PCB不僅充當元件之間的電氣互聯連接,還是放大器排熱的主要途徑(利用封裝底部的金屬塊)。
本文將介紹熱阻概念,並且提供用於從裸片到採用LFCSP或法蘭封裝的典型RF放大器散熱片之熱流動建模技術。
回顧熱概念
熱流
材料不同區域之間存在溫度差時,熱量從高溫區流向低溫區。此一過程與電流類似,電流經由電路,從高電勢區域流向低電勢區域。
材料不同區域之間存在溫度差時,熱量從高溫區流向低溫區。此一過程與電流類似,電流經由電路,從高電勢區域流向低電勢區域。
熱阻
所有材料都具有一定的導熱性。熱導率是衡量材料導熱能力的標準。熱導率值通常以瓦特每米開爾文(W/mK)或瓦特每英寸開爾文(W/inK)為單位。如果已知材料的熱導率,則採用以下公式,以C/W或K/W為單位計算材料單位體積的熱阻(θ):
所有材料都具有一定的導熱性。熱導率是衡量材料導熱能力的標準。熱導率值通常以瓦特每米開爾文(W/mK)或瓦特每英寸開爾文(W/inK)為單位。如果已知材料的熱導率,則採用以下公式,以C/W或K/W為單位計算材料單位體積的熱阻(θ):
其中:
Length表示材料的長度或厚度,以公尺為單位。
k為材料的熱導率。
Area表示橫截面積,以m2為單位。
Area表示橫截面積,以m2為單位。
溫度
利用熱流量等效於電流量的類比,本身具備熱阻且支援熱流流動的材料的溫差如下:
∆T = Q × θ (2)
利用熱流量等效於電流量的類比,本身具備熱阻且支援熱流流動的材料的溫差如下:
∆T = Q × θ (2)
其中:
∆T表示材料不同區域之間的溫差(K或°C)。
Q表示熱流(W)。
θ表示材料的熱阻(C/W或K/W)。
∆T表示材料不同區域之間的溫差(K或°C)。
Q表示熱流(W)。
θ表示材料的熱阻(C/W或K/W)。
元件的熱阻
元件的熱阻相當複雜,往往與溫度呈非線性關係。因此,我們採用有限元分析方法建立元件的熱模型。紅外線攝影技術可以確定元件連接處的溫度和操作期間封裝的溫度。基於這些分析和測量結果,可以確定等效的熱阻。在對元件實施測量的特定條件下,等效熱阻是有效的,一般是在最大操作溫度下。
參考表1,查看典型的RF放大器的絕對最大額定值表。
表1.典型的RF放大器的絕對最大額定值
|
參數 |
額定值 |
|
漏極偏置電壓(VDD) |
60 V dc |
|
閘極偏置電壓(VGG1) |
-8 V至0 V dc |
|
射頻(RF)輸入功率(RFIN) |
35 dBm |
|
連續功耗(PDISS) (T = 85°C)(85°C以上以636 mW/°C減額) |
89.4 W |
|
熱阻,結至焊墊背面(θJC) |
1.57°C/W |
|
溫度範圍 : |
|
|
儲存 |
-55°C至+150°C |
|
工作溫度 |
-40°C至+85°C |
|
保持百萬小時平均無故障時間(MTTF)的接面溫度範圍(TJ) |
225°C |
|
標稱接面溫度(TCASE = 85°C,VDD = 50 V) |
187°C |
對於LFCSP和法蘭封裝,假定封裝外殼是封裝底部的金屬塊。
最高接面溫度
在給定的產品資料手冊中,會在絕對最大額定值表中給出每個產品的最大接面溫度(基於元件的半導體製程)。在表1中,指定的維持百萬小時MTTF的最大接面溫度為225℃。指定的這個溫度一般適用於氮化鎵(GaN)元件。超過這個限值將會導致元件的壽命縮短,且出現永久性的元件故障。
在給定的產品資料手冊中,會在絕對最大額定值表中給出每個產品的最大接面溫度(基於元件的半導體製程)。在表1中,指定的維持百萬小時MTTF的最大接面溫度為225℃。指定的這個溫度一般適用於氮化鎵(GaN)元件。超過這個限值將會導致元件的壽命縮短,且出現永久性的元件故障。
工作溫度範圍
元件的工作溫度(TCASE)已在封裝底座上給出。TCASE是封裝底部金屬塊的溫度。工作溫度不是元件周圍空氣的溫度。
如果已知TCASE和PDISS,則很容易計算得出接面溫度(TJ)。例如,如果TCASE=75°C,PDISS=70 W,則可以使用以下公式計算TJ:
TJ = TCASE + (θJC × PDISS)
= 75°C + (1.57°C/W × 70 W)
= 184.9°C
TJ = TCASE + (θJC × PDISS)
= 75°C + (1.57°C/W × 70 W)
= 184.9°C
考量到元件的可靠性時,TJ是最重要的規格參數,決不能超過此數值。相反的,如果可以透過降低PDISS,使TJ保持在最大可允許的水準之下,則TCASE可以超過指定的絕對最大額定值。在此例中,當外殼溫度超過指定的最大值85°C時,可使用減額值636 mW/°C來計算最大可允許的PDISS。例如,使用表1中的資料,當PDISS的限值為83 W時,可允許的最大TCASE為95°C。PDISS可使用以下公式計算:
PDISS = 89.4 W − (636 mW/°C × 10°C)
= 83 W
PDISS = 89.4 W − (636 mW/°C × 10°C)
= 83 W
使用此PDISS 值,可以計算得出225°C接面溫度,計算公式如下:
TJ = TCASE + (θJC × PDISS)
= 95°C + (1.57°C/W × 83 W) (3)
TJ = TCASE + (θJC × PDISS)
= 95°C + (1.57°C/W × 83 W) (3)
元件和PCB環境的熱模型
為了充分瞭解元件周圍的整個熱環境,必須對元件的散熱路徑和材料進行建模。圖1顯示了安裝在PCB和散熱片上的LFCSP封裝的截面原理圖。在本例中,裸片生熱,然後經由封裝和PCB傳輸到散熱片。要確定元件連接處的溫度,必須計算熱阻。利用熱阻與熱流,可計算得出接面溫度。然後將接面溫度與最大指定接面溫度進行比較,以確定元件是否可靠地運行。
在圖1中,元件連接處到散熱片的散熱路徑定義如下:
• θJA是元件連接處到封裝頂部周圍空氣的熱阻。
• θJC是連接處到外殼(封裝底部的金屬塊)的熱阻。
• θSN63是焊料的熱阻。
• θCU是PCB上鍍銅的熱阻。
• θVIACU是通孔上鍍銅的熱阻。
• θVIASN63是通孔中填充的焊料的熱阻。
• θPCB是PCB層壓材料的熱阻。
• θJA是元件連接處到封裝頂部周圍空氣的熱阻。
• θJC是連接處到外殼(封裝底部的金屬塊)的熱阻。
• θSN63是焊料的熱阻。
• θCU是PCB上鍍銅的熱阻。
• θVIACU是通孔上鍍銅的熱阻。
• θVIASN63是通孔中填充的焊料的熱阻。
• θPCB是PCB層壓材料的熱阻。
在典型電路板中,包含多個通孔和多個PCB層。在計算系統截面的熱阻時,會使用熱電路計算各個熱阻,並將串聯熱阻與並聯熱阻結合起來,以此確定元件的總熱阻。
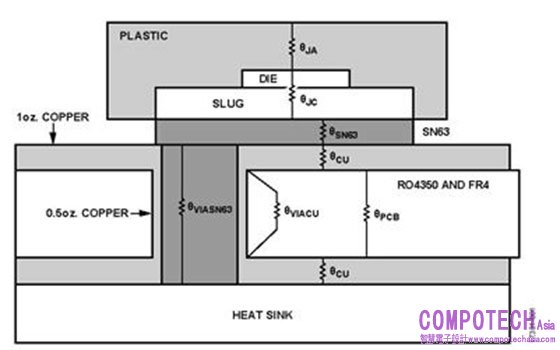
圖1.安裝在PCB和散熱片上的LFCSP封裝的熱模型
系統的熱阻計算
對於每個散熱路徑,都使用公式1來計算其熱阻。要計算得出各個熱阻值,必須已知材料的熱導率。請參見表2,查看PCB總成中常用材料的熱導率。
對於每個散熱路徑,都使用公式1來計算其熱阻。要計算得出各個熱阻值,必須已知材料的熱導率。請參見表2,查看PCB總成中常用材料的熱導率。
表2.常用PCB材料的熱導率
|
材料 |
熱導率(W/inK) |
|
銅(Cu) |
10.008 |
|
鋁(Al) |
5.499 |
|
Rogers 4350 (RO4350) |
0.016 |
|
FR4或G-10層壓材料 |
0.008 |
|
氧化鋁(Al2O3) |
0.701 |
|
SN63焊料 |
1.270 |
|
導熱環氧樹脂 |
0.020 |
|
砷化鎵(GaAs) |
1.501 |
|
模塑膠 |
0.019 |
圖2基於圖1中所示的熱模型,顯示等效的熱電路。TPKG表示封裝底部的溫度,TSINK表示散熱片的溫度。在圖2中,假設封裝(TA)周圍的環境空氣溫度恒定不變。對於外層包有外殼的真實總成,TA可能隨著功耗增加而升高。本分析忽略了散熱路徑至環境空氣的溫度,因為對於具有金屬塊的LFCSP和法蘭封裝,θJA要遠大於θJC。

圖2.等效的熱電路
熱阻示例:HMC408LP3評估板
HMC408LP3功率放大器採用一塊0.01英寸厚,由Rogers RO4350層壓板構成的評估板。圖3所示的接地焊墊面積為0.065 × 0.065英寸,上有5個直徑為0.012英寸的通孔。電路板頂部和底部分別有1盎司鍍銅(0.0014英寸厚)。通孔採用½盎司銅進行鍍層(0.0007英寸厚)。裝配期間,會在通孔中填塞SN63焊料。分析顯示,幾乎所有的熱流都會流經焊料填塞的通孔。因此,在本分析中,餘下的電路板佈局都可忽略。
圖3.接地焊墊佈局
各個熱阻都使用公式1計算得出。計算θSN63時,採用的SN63焊料的熱導率為1.27 W/inK,長度(或者焊接點的厚度)為0.002英寸,焊接面積為0.004225英寸(0.065英寸× 0.065英寸)。
接下來,以相似方式計算PCB頂部的銅鍍層的值。銅鍍層的熱導率為10.008 W/inK,長度為0.0014 英寸(1盎司銅),鍍層面積為0.00366平方英寸(in2)。
對於通孔上銅鍍層的面積,採用以下公式進行計算
面積 = π × (rO2 – rI2) (6)
面積 = π × (rO2 – rI2) (6)
其中:
rO表示外徑。
rI表示內徑。
外徑為0.006英寸,內徑為0.0053英寸時,計算得出的面積為0.00002485 in2。通孔的長度為板的厚度(0.01英寸),銅的熱導率為10.008 W/inK。
rO表示外徑。
rI表示內徑。
外徑為0.006英寸,內徑為0.0053英寸時,計算得出的面積為0.00002485 in2。通孔的長度為板的厚度(0.01英寸),銅的熱導率為10.008 W/inK。
因為並排存在5個通孔,所以熱阻要除以5。所以,θVIACU = 8.05°C/W。
以相似方式計算得出通孔的填塞焊料的值。
因為存在5個填塞通孔,所以等效熱阻為θVIASN63 = 17.85°C/W。
接下來,使用0.01英寸長度、0.016 W/inK的Rogers RO4350熱導率,以及0.00366 in2面積計算PCB的熱阻。
在圖2所示的等效熱電路中,三個熱阻(θPCB、θVIACU和θVIASN63)並聯組合之後為5.37°C/W。在通孔中填塞焊料之後,熱阻從8.05°C/W降低至5.37°C/W。最後,加上熱阻串聯的值,可以得出整個PCB總成的熱阻。
θASSY = θSN63 + θCU + θEQUIV + θCU = 0.372 + 0.038 + 5.37 + 0.038 = 5.81°C/W (10)
其中,θASSY表示總成的熱阻。
確定功耗
熱阻值確定後,必須確定熱流(Q)值。對於RF元件,Q的值表示輸入元件的總功率和元件輸出的總功率之間的差值。總功率包括RF功率和直流功率。
Q = PINTOTAL − POUTTOTAL = (PINRF + PINDC) − POUTRF (11)
其中:
PINTOTAL表示直流功率和RF輸入功率之和。
POUTTOTAL表示元件輸出的功率,與POUTRF相同。
PINRF表示RF輸入功率。
PINDC表示直流輸入功率。
POUTRF表示傳輸至負載的RF輸出功率。
圖4.HMC408LP3功耗與輸入功率
對於HMC408LP3功率放大器,使用公式11來計算圖4中所示的PDISS的值。圖4顯示了放大器的以下特性:
• 元件消耗約4 W功率,無RF輸入訊號。
• 採用RF訊號時,PDISS的值由頻率決定。
• 存在某一個輸入功率,元件的功耗最低。
• 元件消耗約4 W功率,無RF輸入訊號。
• 採用RF訊號時,PDISS的值由頻率決定。
• 存在某一個輸入功率,元件的功耗最低。
根據等效熱阻、θTOTAL和Q,可以使用以下公式計算得出接面溫度
ΔT = Q × θTOTAL (12)
θTOTAL = θASSY + θJC = 5.81 + 13.79 = 19.6°C/W (13)
ΔT = Q × θTOTAL (12)
θTOTAL = θASSY + θJC = 5.81 + 13.79 = 19.6°C/W (13)
對於無RF輸入功率的靜止狀態,Q = 4 W,且
∆T = 4.0 × 19.6 = 78.4°C (14)
∆T = 4.0 × 19.6 = 78.4°C (14)
因為指定的HMC408LP3的最大接面溫度為150°C,所以在PDISS = 4 W時,散熱片的溫度必須≤71.6°C(也就是說,78.4°C + 71.6°C = 150°C)。
HMC408LP3功率放大器正常運行時(例如,輸入功率≤ 5 dBm),功耗小於4 W,這表示散熱片的溫度可以稍微高於71.6°C。但是,如果放大器在深度壓縮環境中工作,且輸入功率等效於15 dBm,則PDISS升高,且要求散熱片的溫度低於71.6°C。
表3.熱工作資料表
|
描述 |
值 |
單位 |
注釋 |
|
散熱片最高溫度 |
70 |
°C |
|
|
θASSY |
5.81 |
°C/W |
從等效熱電路計算得出 |
|
θJC |
13.79 |
°C/W |
來自產品資料手冊 |
|
θTOTAL |
19.6 |
°C/W |
添加θASSY和θJC |
|
Q |
4.0 |
W |
|
|
得出的接面溫度 |
148.4 |
°C |
散熱片最高溫度 + (θTOTAL × Q);不超過資料手冊中列出的最大通道溫度 |
可靠性
元件的預期壽命與工作溫度密切相關。在低於最大接面溫度的溫度下運行可以延長元件的使用壽命。超過最大接面溫度會縮短使用壽命。因此,實施熱分析可以確保在預期的操作條件下不會超過指定的最大接面溫度。
結論
使用採用LFCSP和法蘭封裝的低接面溫度表貼RF功率放大器來圍裝熱阻迫使PCB不僅要充當元件之間的RF互連,還要用作導熱路徑以導走功率放大器的熱量。
因此,θJC 取代θJA,成為衡量LFCSP或法蘭封裝的重要熱阻指標。
在這些計算中,最關鍵的指標是RF放大器的接面溫度或通道溫度(TJ)。只要不超過最大接面溫度,那麼其他標稱限值,例如TCASE,則可以高於限值。