愛德萬測試研發出用於記憶測試系統STT-MRAM的切換電流測量系統
前言:
與日本東北大學CIES共同合作研究開發,向STT-MRAM故障分析及實務應用方面向前跨出一大步
2018年10月31日--半導體測試設備領導供應商愛德萬測試(東京證交所:6857)宣布其與日本東北大學創新整合電子系統中心〈CIES〉的合作,本計畫由東北大學電機研究所教授遠藤哲夫主持,成功地研發出高速、高精確度模組,可以測量磁性隨機存取記憶體〈STT-MRAM〉中記憶束的切換電流,這是眾所期待用於愛德萬測試記憶測試系統的次世代記憶技術,運作速度為微安培/奈米秒。由於這項科技的創新,使得觀察STT-MRAM記憶單元每分鐘通過電流變化成為可能,此外,由於運用新研發技術開發成功的此測試系統,也讓STT-MRAM故障分析及STT-MRAM技術實務應用又向前跨出了一大步。這項測試科技除應用於STT-MRAM系統外,也可用於其他如ReRAM及PCRAM電阻改變類的記憶系統上。
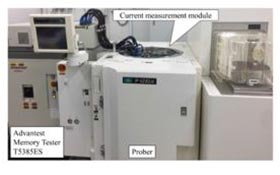
愛德萬T5385ES記憶測試系統及用於STT-MRAM評估的測試環境
STT-MRAM記憶單元由磁隧結〈MTJs〉及晶體管組成,記憶單元堆疊排列,形成儲存器陣列。一個MTJ就是一個非揮發性記憶元素,運用磁阻效應記錄資料。除了不需搭配備用電源外,STT-MRAM結合了所有高速操作、低電壓操作及高重寫容差的特色,據說這是其他非揮發性記憶技術所難以達到的境界。全球各研究機構及公司目前都在進行STT-MRAM的研發。
此項新科技除了能應用在研發,另外用於大量生產、高效率及使用記憶測試系統的績效評估正確性都非常重要。然而,目前STT-MRAM的切換是隨機的現象,利用電子的量子機械性以及熱誘發波動;此外,這些電流非常弱,一般低於100微安培甚至更小,出現的時間也僅僅數奈米秒,因為即使測量設備可能量測在單一隧結處或單一記憶電池中的磁力切換,但對於多重記憶單元中的儲存器陣列的測量仍有困難。
愛德萬測試及東北大學CIES攜手合作研發出用於愛德萬測試系統的高精密度、高速電流測試模組,成功的執行了實驗測量電阻內每分鐘的變化以及在STT-MRAM切換操作過程中電流每奈米秒單位間的轉變次數。實驗中,由包含一個MTJ及一個晶體管組成的記憶單元STT-MRAM測試晶片,裝置於一個工業用標準尺寸300毫米的矽晶圓上,成為原型,晶圓表面整體都進行測量。這項研究的成功為高效率與高精密度STT-MRAM分析錯誤技術的發展樹立了新的里程碑。期望這項成功可以改善生產率,並提升STT-MRAM的實用性。
縱坐標:電流〈微安培,μA〉
白色脈衝寬度
橫坐標:時間〈奈米秒〉
〈圖〉STT-MRAM切換電流測量實例。切換中電流變換時間〈圖中水平軸的長度是電流由IRAP轉換為IRP的時間〉隨切換操作而改變的情形。此記憶測試系統測量了分鐘差異,以每奈米秒中變化的微安培量進行測量。
成功的實驗植基於愛德萬測試與東北大學CIES聯盟及OPERA〈Program on Open Innovation Platform with Enterprises, Research Institute and Academia〉計畫,共同合作研究的成果。東北大學CIES會繼續此研究開發計畫,祈能使新的具備外部磁場應用機制的STT-MRAM記憶測試系統商品化。
此研究結果於2018年10月22至24日,在仙台市舉行的IEEE非揮發性記憶技術研討會中發表。
*OPERA計畫是以促進業界與學界合作為目的的平台。會員包括東北大學、京都大學、山形大學,以及一群居於領導地位的業界公司。東北大學是本計畫的協調人。
關於愛德萬測試
愛德萬測試是世界知名的半導體自動測試設備領導供應商,專為電子設備與系統設計與製造廠商提供首屈一指量測設備。現今全球最先進半導體生產線均採用該公司領先業界的系統與產品。此外,該公司亦深耕奈米和太赫茲 (terahertz) 技術的發展,積極開發新興市場,近日更推出攸關光罩製造的多視角量測掃描式電子顯微鏡,以及突破現有技術限制的3D成像暨分析工具。該公司在1954年於東京成立,並在1982年於美國成立第一家子公司,迄今子公司遍佈全球。進一步資訊請至公司網站www.advantest.com
愛德萬測試是世界知名的半導體自動測試設備領導供應商,專為電子設備與系統設計與製造廠商提供首屈一指量測設備。現今全球最先進半導體生產線均採用該公司領先業界的系統與產品。此外,該公司亦深耕奈米和太赫茲 (terahertz) 技術的發展,積極開發新興市場,近日更推出攸關光罩製造的多視角量測掃描式電子顯微鏡,以及突破現有技術限制的3D成像暨分析工具。該公司在1954年於東京成立,並在1982年於美國成立第一家子公司,迄今子公司遍佈全球。進一步資訊請至公司網站www.advantest.com