半導體製程大躍進! 軟性混合電子的輕薄、大面積且可彎曲的特性,被視為是未來電子產業發展的方向與機會,根據Mordor Intelligence資料顯示,軟性混合電子產品市場,預計從2018年到2023年期間,以13.2%的年複合成長率發展。看好此趨勢,工研院在經濟部技術處支持下,於今(5)日開幕的SEMICON Taiwan 2018(2018國際半導體展)中,展出一連串以面板級扇出型封裝技術所開發的軟性混合電子應用成果,突破傳統半導體封裝製程以晶圓為載體的方式,將晶片載置在面板,以面板級製程技術整合軟性可拉伸材料與結構設計,以達到軟性可撓的特點,提供軟性混合電子、穿戴式裝置、車用電子等領域技術開發與產品應用。
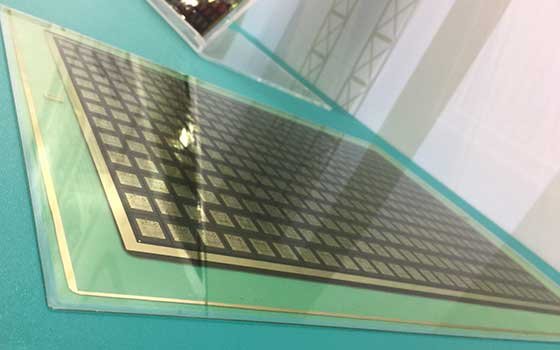
工研院此次於SEMICON Taiwan 2018展出的技術包括「超低翹曲面板級扇出封裝結構」、「軟性混合電子之高解析重佈線層雛型品」、「穿戴式可拉伸電路基板」、「軟性混合電子之精準運動偵測系統」等軟性混合電子材料與零組件技術成果,顯現台灣除為全球周知的晶圓、封測重鎮外,在軟性混合電子供應鏈的不同環節亦提供多元解決方案,同時展現工研院於經濟部技術處支持下,在5+2產業創新政策中「亞洲.矽谷」與「晶片設計與半導體」之研發成果。

工研院主題館今年在國際半導體展的亮點展示技術如下:
「超低翹曲面板級扇出型封裝結構」 平整創造更高良率
面板級扇出型封裝(FOPLP , Fan-out Panel Level Packaging)因載具面積大,對降低生產成本有顯著的助益,為扇出型封裝技術發展的驅動力。但同時也面臨許多挑戰;其中,面板級扇出型封裝由於載板尺寸更大,膜層堆疊往往會造成更嚴重的翹曲,導致整體良率的下降。為此,工研院開發低應力面板級扇出型封裝技術,克服傳統模封造成之翹曲問題,並結合機械式取下,提供完整解決方案,可應用於下世代高性價比、高整合度IC封裝領域。
「超低翹曲面板級扇出型封裝結構」 平整創造更高良率
面板級扇出型封裝(FOPLP , Fan-out Panel Level Packaging)因載具面積大,對降低生產成本有顯著的助益,為扇出型封裝技術發展的驅動力。但同時也面臨許多挑戰;其中,面板級扇出型封裝由於載板尺寸更大,膜層堆疊往往會造成更嚴重的翹曲,導致整體良率的下降。為此,工研院開發低應力面板級扇出型封裝技術,克服傳統模封造成之翹曲問題,並結合機械式取下,提供完整解決方案,可應用於下世代高性價比、高整合度IC封裝領域。

「軟性混合電子之高解析重佈線層雛型品」 持續向下世代製程邁進
工研院以自有FlexUPTM軟性基板和軟性顯示核心技術為基礎,整合開發4層重佈線層(RDL)之面板級扇出型晶片封裝,其中重佈線層銅導線之線寬最小可達1.2微米,除可支
工研院以自有FlexUPTM軟性基板和軟性顯示核心技術為基礎,整合開發4層重佈線層(RDL)之面板級扇出型晶片封裝,其中重佈線層銅導線之線寬最小可達1.2微米,除可支
援的I/O數量大增外,具備可大量產製造、晶片封裝厚度薄化與省電等特性,格外適用於智慧手持裝置與物聯網等高階運算晶片,提供軟性穿戴、可攜式行動裝置之高精度運算之晶片產品封裝策略,解決以往技術難以提升接腳密度的瓶頸,具備超薄可撓曲的優勢,可應用於依人體曲線自由伸縮、彎曲、微小化之穿戴產品。
「軟性混合電子之精準運動偵測系統」 運動的力道它知道
智慧化科技電子系統產品樣式除了輕薄之外,也要求穿戴舒適。工研院此次展出的「軟性混合電子之精準運動偵測系統」,以面板級扇出型封裝核心技術為基礎,結合高精準度之訊號偵測系統,利用無線傳輸技術即時將使用者身上的肌電訊號傳輸至電腦,藉由演算法判讀其肌肉用力程度及疲勞度,特殊的動態精準度提升設計,改善電極因脫落造成訊號失真問題,以增加量測精準度,結合運動訓練的知識,提供兼具精準量測與舒適穿戴新體驗未來可作為運動員訓練或是教練調度選手的依據。
智慧化科技電子系統產品樣式除了輕薄之外,也要求穿戴舒適。工研院此次展出的「軟性混合電子之精準運動偵測系統」,以面板級扇出型封裝核心技術為基礎,結合高精準度之訊號偵測系統,利用無線傳輸技術即時將使用者身上的肌電訊號傳輸至電腦,藉由演算法判讀其肌肉用力程度及疲勞度,特殊的動態精準度提升設計,改善電極因脫落造成訊號失真問題,以增加量測精準度,結合運動訓練的知識,提供兼具精準量測與舒適穿戴新體驗未來可作為運動員訓練或是教練調度選手的依據。
能屈能伸!「穿戴式可拉伸電路基板」 運動照護好幫手
隨著穿戴裝置越加普及,新世代的電路基板不僅設計上更求輕薄短小,另一個亟待克服的挑戰,便是要可彎折、可拉伸,以因應電子產品緊密貼附體表、精準量測生理資訊的需求。然而現階段應用於手機、平板的印刷電路板(PCB)無法彎折,開始運用於可撓裝置的軟性電路板(FPCB)雖可彎曲、卻還無法做到拉伸。工研院獨家研發出既可撓、更可拉伸的「穿戴式可拉伸電路基板」,以耐高溫的高分子材料為基板取代傳統硬質基板,再於基板上製作耐高溫製程的導電電路,以解決現有電路基板易碎、笨重與不易攜帶的問題,同時也避免在體表撓曲時,電路拉伸所造成訊號的損失。此項技術「可彎曲的柔軟身段」,除應用於穿戴裝置外,亦可進一步與織物結合,製成護腕、護膝,完整包覆於肌肉和關節,為運動選手與需要照護的長者,偵測肌電(EMG)與心電(ECG)訊號,提供有如運動教練、居家照護員的貼心服務。
隨著穿戴裝置越加普及,新世代的電路基板不僅設計上更求輕薄短小,另一個亟待克服的挑戰,便是要可彎折、可拉伸,以因應電子產品緊密貼附體表、精準量測生理資訊的需求。然而現階段應用於手機、平板的印刷電路板(PCB)無法彎折,開始運用於可撓裝置的軟性電路板(FPCB)雖可彎曲、卻還無法做到拉伸。工研院獨家研發出既可撓、更可拉伸的「穿戴式可拉伸電路基板」,以耐高溫的高分子材料為基板取代傳統硬質基板,再於基板上製作耐高溫製程的導電電路,以解決現有電路基板易碎、笨重與不易攜帶的問題,同時也避免在體表撓曲時,電路拉伸所造成訊號的損失。此項技術「可彎曲的柔軟身段」,除應用於穿戴裝置外,亦可進一步與織物結合,製成護腕、護膝,完整包覆於肌肉和關節,為運動選手與需要照護的長者,偵測肌電(EMG)與心電(ECG)訊號,提供有如運動教練、居家照護員的貼心服務。